半導體工業技術不斷的進步,芯片制成工藝越來越精細化,同時必然會導致保持良品率的挑戰難度越來越高,而一塊潔凈,均一,完*的晶圓(wafer)是后續所有工藝有效實施的前提。為了保證質量,*理想的狀態是晶圓出廠前每片一檢并分類保證其出廠品質;而在進行精細制程前也每片一檢并分類,用于進一步規避晶圓轉運,存儲等環節不當操作造成的污染。
因此帶來了無圖型晶圓)檢測應用的兩個需求要點:
第一是最小靈敏度,即設備能夠檢測到晶圓表面缺陷的最小尺度,最好成做到與芯片制程有可比性的小尺度。
第二是吞吐量,即單位時間能夠完成的晶圓檢測量,最好是能做到制程前每片一檢。
對于此類無圖型晶圓檢測應用,基于光學的激光散射法比起電子束法和x射線法在吞吐量上具備碾壓性的優勢。

圖一.激光散射法做無圖型晶圓檢測
如圖一.激光光束經過聚焦鏡以一定的傾斜角照射到晶圓表面,大部分激光會發生鏡面反射然后被人工放置的激光吸收器(damper)吸收,小部分會被晶圓表面吸收,極小部分會向各個方向散射。我們在垂直的方向放置一個探測器檢測散射光的強度,通過晶圓的高速旋轉疊加徑掃描實現對于晶圓上所有點的檢測。正常狀態下探測器檢測到的是微弱的散射本底,向而當激光光束掃描照射到晶圓上的瑕疵時,由于瑕疵點的微區散射率會小幅度直至大幅度的增加,探測器輸出的信號強度也會等比的變化,以此我們實現了晶圓上瑕疵點的掃描檢測。
這些可以導致微區散射率變化的瑕疵包括:
1)顆粒污染(Particle):如微小塵埃、金屬顆粒、有機殘留;
2)劃痕與機械損傷(Scratches):比如由拋光或搬運過程中造成的細微劃痕;
3)晶格缺陷(Crystal Defects):如晶格位錯、層錯等微觀結構異常;
4)表面凹坑與凸起(Pits & Bumps):包括納米級凹坑、凸起、表面粗糙度異常
5)殘留膜或堆積物(Residue Deposits):一些在制程工藝中未完*去除的沉積物。
大致有這樣一些實驗規律:
1) 激光波長越短,可實現缺陷檢測的最小尺度越精細,所以對于高*高精細度的半導體制程,默認是采用266nm甚至更短波長的激光器以保證檢測到盡可能更小尺度的瑕疵(大致可做到約20-30nm的最小靈敏度),另外深紫外DUV激光的穿透深度很淺(如266nm激光對于硅片的穿透深度1-10nm); 所以DUV激光比較適合于檢測晶圓表面缺陷。
2) 激光波長越則對于晶片的穿透性越好,比如對于硅片而言,532nm激光的穿透深度約1-5um;而1064nm近紅外激光可穿透硅片。所以相對而言,可見光激光適合于同時檢測到淺表層的內部缺陷,而紅外激光適合于同時檢測到晶圓內部缺陷。
3) 以266nm激光為例,照射到晶片完好面發生的是鏡面反射,其伴生的散射是瑞利散射,散射強度大致僅為激光功率的0.1%;而掃描到納米尺度的微小缺陷點時(20-100nm);其發生的散射時米散射,散射強度會增大到0.5%-3%,由此可見,當無圖型晶圓檢測掃描到納米尺度缺陷點時,設備會檢測到一個信號的突變,以此來定位缺陷點位置。當缺陷尺度達到微米量級(比如劃痕等機械損傷)其散射是幾何散射(或稱邊沿散射),其散射強度甚至可達3%-10%;一個設計良好的數據處理軟件可以通過數據建模辨別哪里有缺陷,有什么大小的缺陷和那種形式的缺陷。
結合以上的實驗規律,我們大致介紹一下做無圖型晶圓檢測所需激光器的選型以及歷史沿革。
在大致1980年前后,就已經有基于激光激發的半導體晶圓檢測設備了,彼時一般采用的是氦氖(HeNe-632.8nm),氦鎘(HeCd-325nm/442nm),氬離子(Arion488nm/514nm)激光器,激光功率是mW到幾十mW量級,能耗從幾十瓦到上百瓦不等;少數水冷氬離子激光器有瓦量級激光輸出,能耗為千瓦級。氣體激光器工作穩定,價格便宜。但同時也存在一些問題,比如:
-激光轉化效率很低,導致體積較大,能耗較高
-激光管壽命一般在幾千小時,7天24小時工業應用下需要頻繁更換激光管
-很難做到紫外波段,輸出功率較低
基本在1990年后,上述氣體激光器就已經逐漸被新涌現的半導體泵浦的全固態激光器(DPSSL-Diode Pumped Solid State Laser)所取代(如果一些老設備的氬離子Ar,氦鎘HeCd激光器的換管或更新業務,您可咨詢聯系先鋒科技公司)
繼續講,半導體泵浦的全固態激光器除了成本高導致價格較高之外,其余全部是優點
-能量轉化效率高,導致體積小,能耗低
-激光器壽命通常超過1萬小時,哪怕7天24小時工業應用也很少需要維護
-基頻輸出功率很容易做到百瓦以上,從而有實力級聯接駁倍頻晶體以及和頻晶體,達成較高功率的紫外乃至深紫外激光輸出,比如基于1064nm基頻輸出的DPSS激光器,
接駁一級倍頻晶體,則獲得532nm二倍頻輸出
接駁一級倍頻晶體加一級和頻晶體,則獲得355nm三倍頻輸出
接駁兩級級聯的倍頻晶體,則獲得266nm四倍頻輸出
接駁一級倍頻晶體加一級三倍頻晶體,則獲得213nm五倍頻輸出
對于全固態激光器,266nm甚至213nm的深紫外輸出實驗室以做到瓦級,商品化設備以百毫瓦級別為推薦。對于無圖型晶圓檢測應用的激光選型上,三個小貼士:
1) 激光波長越短,則可測缺陷最小尺度越小,213nm/193nm在波長上相對有優勢
2) 激光輸出波長越短,激光系統價格越貴,激光輸出功率越低,特別是考慮到價格成本上,266nm的數百毫瓦的全固態激光被認為是一個性價比較高的選擇。
3) 對于深紫外激光器哪怕是百毫瓦量級的輸出,對于最后一級紫外晶體而言,也是一個比較沉重的負擔,通常而言大致幾百到一千小時的連續工作就會產生明顯的衰減,所以較高*的深紫外全固態激光器會在最后一級非線性晶體上設計電動切換裝置,在一個工作點即將到壽命時切換到下一個工作點,以此保證上萬工作小時的壽命。后續提及的三款266/213/193nm全固態激光器均由此配置。
一. 推薦激光器:
1. 德國Crylas公司 FQCW266nm深紫外全固態激光器
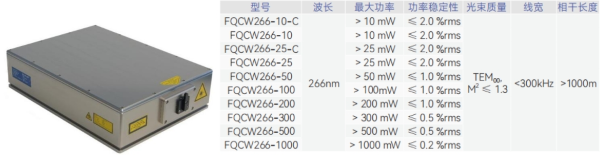
2. 德國Xiton公司Impress 213nm深紫外全固態激光器

3. 德國Xiton公司Ixion 193nm深紫外全固態激光器
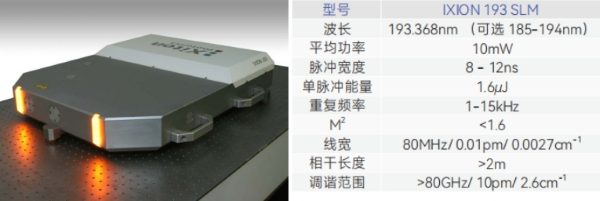
注:此193nm全固態激光器波長短,輸出功率較低,做晶圓檢測相對勉強,在半導體制程行業更適合于做架構掩膜缺陷檢測儀,深紫外超高精度光譜校準等工作。
激光量測設備對晶圓檢測設備的輔助作用。
1. 法國Physics 公司波前分析儀
可用于優化與校準無圖形晶圓缺陷檢測儀的光學系統(比如檢測深紫外顯微物鏡以及深紫外光路系統),也可用于檢測與優化深紫外激光照明指向不穩定度等應用

法國Physics公司SiD4-UV-HR波前探測器
SiD4-UV-HR |
波長范圍 | 190-400 nm |
有效面積 | 13.3×13.3 mm2 |
空間分辨率 | 26μm |
相位/強度采樣數 | 512×512 |
相位分辨率 | <2 nm RMS |
絕對準確度 | 20 nm RMS |
幀速率 | 15 fps |
2. 以色列Ophir公司激光功率能量計:
激光功率計是半導體晶圓檢測設備激光器子部分的系統裝調與維護的常用設備,除此之外還有一些妙用:即時監控激光功率自身的波動并給出反饋信號。我們知道,半導體晶圓檢測設備傾向選用噪聲低的激光器作為光源,其實還有另外一個方式實時歸一化掉激光器自身的噪音。方法很簡單,用一個經過校準的紫外激光分束器,采樣4%-5%的激光功率到激光功率探頭上,剩余的94%-95%激光功率用于晶圓檢測。經過適當的軟件處理,每個時刻的激光功率波動都可以被歸一化掉,以此降低整套系統的噪聲水平,提升信噪比。
推薦配置:
激光功率表頭: VEGA多功能激光功率能量計表頭,USB2.0接口
激光功率探頭1(激光維護裝調用):3A 激光功率探頭,0.19-20um, 10uW-3W測試范圍
激光功率探頭2(實時反饋用):PD300R-UV 激光功率探頭,200-1100nm, 20pW-300mW測試范圍

關于先鋒科技
先鋒作為專業的科技產品代理,為您構建起全面覆蓋光電領域的優質設備矩陣——從iccd相機、高速相機、近紅外相機等成像設備,飛秒激光器、固體激光器、半導體激光器、脈沖激光器、染料激光器等激光核心器件,到激光功率計、激光能量計、激光波長計、光束質量分析儀等激光測量儀器;從鎖相放大器、殘余氣體分析儀、光學斬波器、棱鏡耦合儀等分析設備,到光電探測器、光電二極管、氣體探測器、紅外探測器、光電倍增管、X光管、X射線探測器等探測器件,再到色度計、照度計、光譜輻射度計、亮度計等光色測量工具及積分球、像增強器、前置放大器等配套設備,精準適配科研實驗、光電研發、精密檢測、光譜分析等多場景的專業需求。
這些高性能設備將為您的項目提供穩定可靠的技術支持,助力突破研發瓶頸、提升工作效率。持續關注先鋒,獲取代理產品的最新動態、應用方案與專屬服務,讓專業設備為您的創新之路加速!
